服务热线
邮箱:postmasterr@jingyeic.com
 3008038871
3008038871总部地址:深圳市福田区华强北路1019号华强广场A座9H
时间:2021/1/11阅读:1500 关键词:MOS场效应管
设定:传统工艺,栅极顶部到外延层表面多晶硅去除量130 nm/230 nm/310 nm
MOS场效应管电性能参数比较
如下图所示
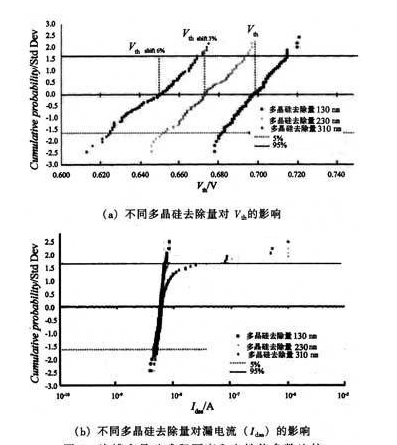
增加多晶硅去除量,即降低阈值开启电压,因此有效沟道的长度变短,源区离子经过侧壁注入沟道,源区结深在沟道表面变深;
漏源间漏电流即有区别
多晶硅去除量=310 nm
会增大部分区域漏电流,若减少多晶硅去除量,随着它减少即慢慢消失,因此刻蚀工艺与MOS场效应管性相关联;
如何解决它们的相关联
即应用突起式多晶硅技术;
如下图所示
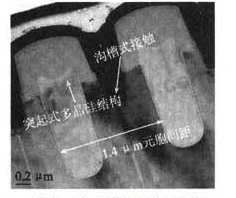
用透射电子显微镜获得突起式TMOS实际截面;
突起式多晶硅结构与沟槽式接触,N型TMOS单位元胞相邻间距=1.4μm
单个芯片有源区面积=0.4 nm2,封装:TSOP6
如下图所示
击穿电压曲线
输出特性曲线
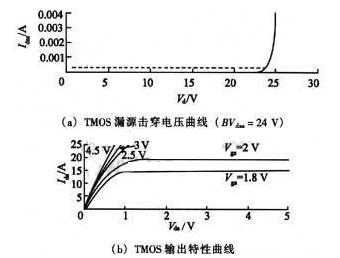
漏端漏电流=250μA 击穿电压=24 V 满足>20 V设计
栅极开启电压=4.5 v 工作电流=5 A,对应导通电阻=23.75 mΩ
芯片有源区尺寸设计=0.4 mm2
Rdson·A=9.5 mΩ·mm2